
苏州纳米所纳米加工平台在β-Ga2O3垂直功率器件方面取得新进展
超宽禁带半导体(UWBG)氧化镓(β-Ga2O3)作为战略性先进电子材料凭借其8 MV/cm优异的超高击穿场强以及独特的大尺寸熔体生长优势,正迅速崛起为后摩尔时代功率电子器件的颠覆性力量。垂直结构功率电子器件通过优化纵向耐压层设计,能够在单位芯片面积内同时实现万伏(10 kV)级的高耐压与千安(kA)级的超大通流能力,完美契合智能电网、新能源汽车、工业电机驱动、数据中心电源以及可再生能源(光伏、风电)变流器等对超高功率密度、高效率、小型化的迫切需求。
近日,中国科学院苏州纳米技术与纳米仿生研究所纳米加工平台在氧化镓(β-Ga2O3)功率器件领域取得两项重要突破:首次基于纳米加工平台开发工艺制备了多鳍通道欧姆接触阳极β-Ga2O3二极管(MFCD),实现超低漏电的千伏级击穿电压;同时研制出高性能增强型垂直β-Ga2O3多鳍晶体管,创下4.3 mΩ·cm²最低比导通电阻纪录。两项成果可为高温高压应用场景提供全新的解决方案。
多鳍通道二极管——打破传统垂直结构限制
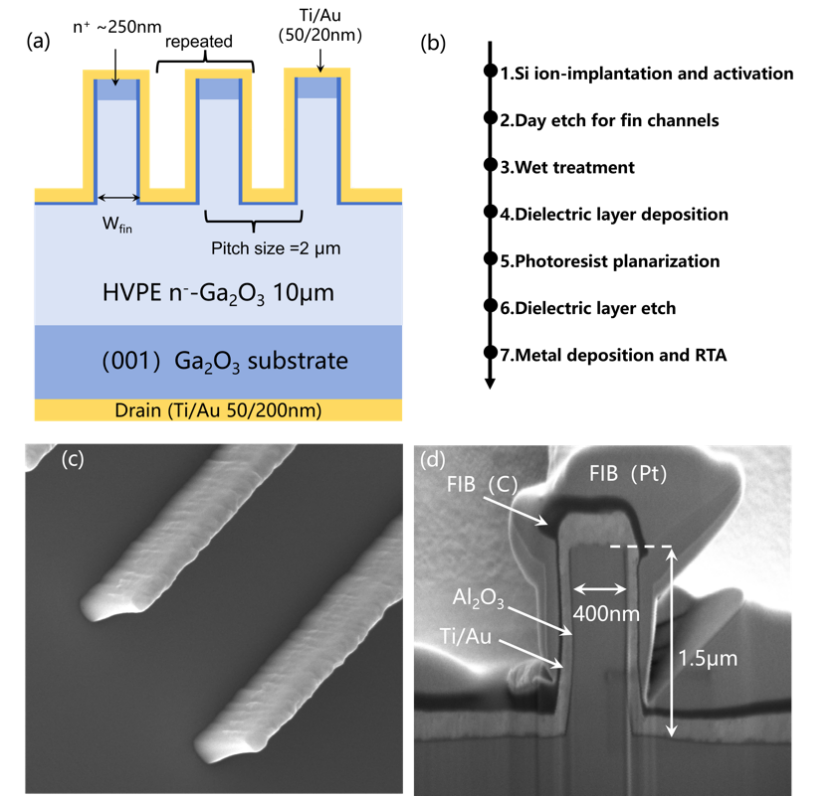
图 1 (a) 多鳍通道 β-Ga2O3二极管的示意图,(b) 器件的关键工艺步骤,(c)鳍干法蚀刻后的扫描电子显微镜(SEM)图像, (d) 鳍宽400 nm二极管 SEM横截面图像。
该器件通过独创的欧姆接触阳极设计替代传统肖特基结构,结合亚微米鳍沟道引发的侧壁自耗尽效应,成功解决了宽禁带半导体器件在高电场下的漏电失控难题。在无任何场板或钝化层辅助的情况下,0.1 μm窄鳍器件展现出1148 V击穿电压,反向漏电流稳定维持在1 μA/cm²的商用水平,且在150 ℃高温环境下未出现性能衰减。欧姆接触的引入使比导通电阻降至7 mΩ·cm²,较同类沟槽肖特基二极管降低35%,这一突破性进展可为光伏逆变器、电动汽车快充桩等高压场景提供全新的解决方案。
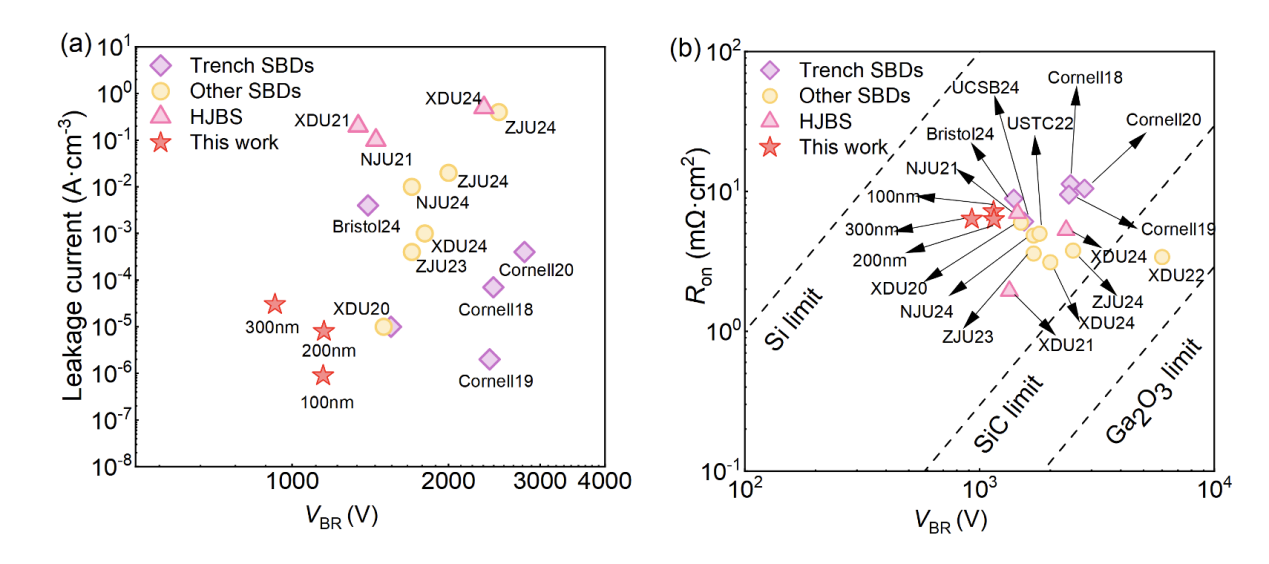
图2 (a) 垂直二极管的漏电流与击穿电压基准性能对比,(b) 本工作中β-Ga2O3垂直二极管和沟槽SBD的导通电阻与击穿电压基准性能对比,以及文献中报道的结果对比。
该成果以Kilovolt-Class β-Ga2O3 Multi-Fin-Channel Diodes with Ohmic-Contact Anode为题发表在功率电子器件领域国际顶级会议IEEE 37th International Symposium on Power Semiconductor Devices and ICs 2025,第一作者为中国科学院苏州纳米所郭高甫和张晓东,通讯作者为张宝顺研究员和河南师范大学戴宪起教授。
增强型垂直晶体管——破解"常开"难题
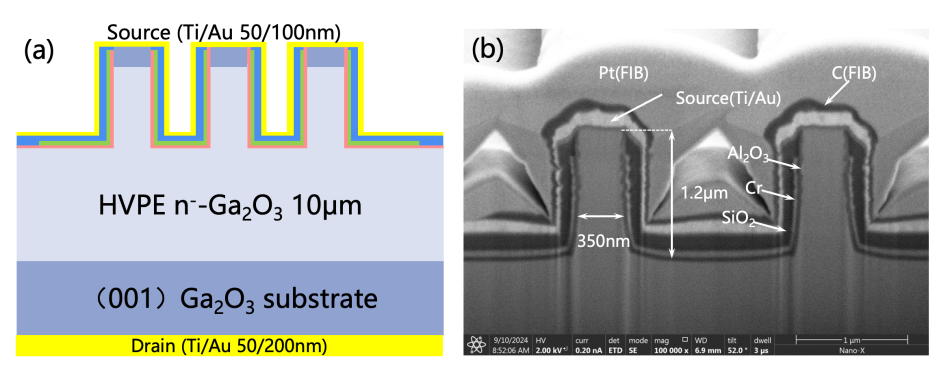
图3 (a) 多鳍通道 β-Ga2O3 FinFET示意图,(b)鳍宽300 nm二极管 SEM 横截面图像。
针对氧化镓材料缺乏p型掺杂的核心瓶颈,研究团队同步研发出国际领先的增强型垂直多鳍晶体管。通过双栅极鳍形沟道几何限域技术,无需依赖p型层即实现可靠常关特性,其阈值电压达0.87 V,开关比突破7×10⁶。创新地采用电子束光刻与非金属掩模刻蚀工艺,实现350 nm鳍宽精度控制,配合双自对准平面化技术精准构筑源漏接触区。最终器件在10 V工作电压下输出760 A/cm²的超高电流密度,比导通电阻仅4.3 mΩ·cm²,同时维持975 V击穿电压与0.22 GW/cm²的优异功率品质因数(PFOM),为数据中心电源及工业电机驱动芯片国产化奠定关键技术基础。
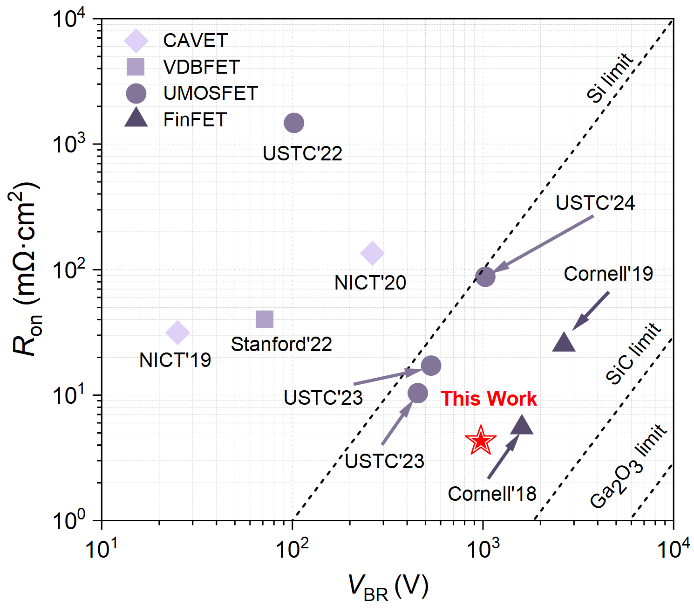
图4 最新垂直β-Ga2O3 MOSFET器件的Vbr与R(on,sp)性能对比图。
该成果以975V/4.3mΩ·c㎡ Enhancement-mode (001) β-Ga2O3 Vertical Multi-fin Power Transistors为题发表在半导体领域国际会议9th IEEE Electron Devices Technology and Manufacturing 2025,第一作者为中国科学院苏州纳米所郭高甫,通讯作者为张宝顺研究员和河南师范大学戴宪起教授。
上述工作得到了国家重点研发计划、国家自然科学基金、南昌重点实验室建设项目、江西省双千计划等项目支持,同时得到了中国科学院苏州纳米所纳米加工平台、测试平台、纳米器件研究部、纳米真空互联实验站(Nano-X)等部门大力支持。
附件下载:

